芯片封装技术前沿突破与未来演进路径探析
- 问答
- 2025-10-26 14:36:44
- 89
当前芯片封装技术正从传统的2D堆叠,向更复杂的3D集成方向快速演进,像台积电的CoWoS等先进封装,通过将不同工艺的芯片像搭积木一样堆叠在一起,显著提升了系统性能并缩小了面积,这种技术对散热和信号完整性提出了巨大挑战,有时甚至需要特殊的冷却液来浸泡芯片以降温,这听起来有点未来感。
未来几年的演进路径可能会聚焦于芯粒(Chiplet)技术的普及,通过将大芯片拆分成多个小芯粒再进行异构集成,可以大幅降低成本、提高设计灵活性,业界正在努力制定统一互联标准,就像为芯粒修建标准化的“高速公路”,但各厂商间的利益协调仍是主要障碍,预计到2030年左右,我们可能会看到更多采用这种模块化方式制造的处理器,用在我们的手机和电脑里。
玻璃基板封装被视作是下一代技术的有力竞争者,与传统有机基板相比,玻璃能提供更佳的平坦度和热稳定性,有利于在更小的空间内容纳更多晶体管,一些领先的公司已经开始进行相关研发,尽管目前成本高昂,但它为未来十年继续延续摩尔定律提供了可能路径。
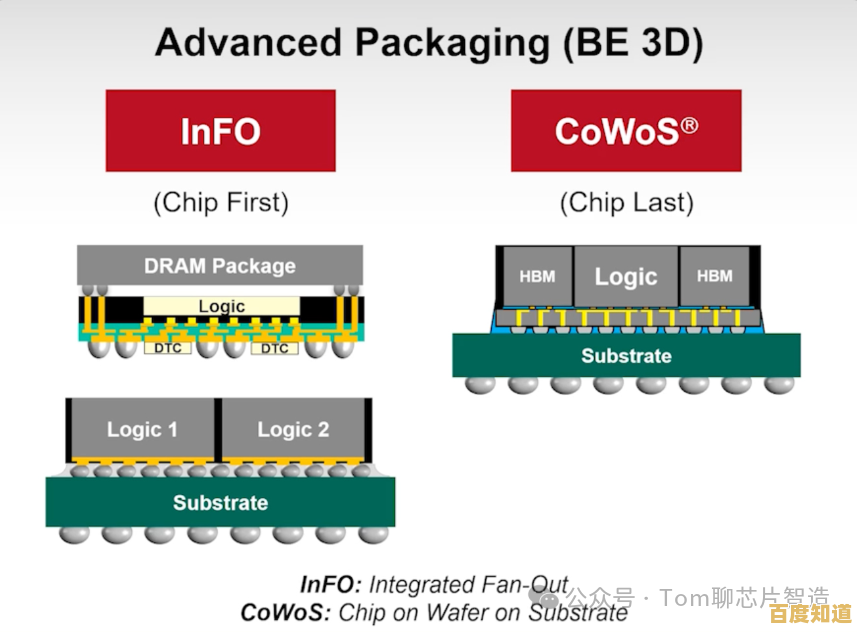
本文由冠烨华于2025-10-26发表在笙亿网络策划,如有疑问,请联系我们。
本文链接:http://pro.xlisi.cn/wenda/62303.html









